激光燒蝕與Xe等離子體FIB-SEM配對:半導體行業大規模物理故障分析中的精確端點方法
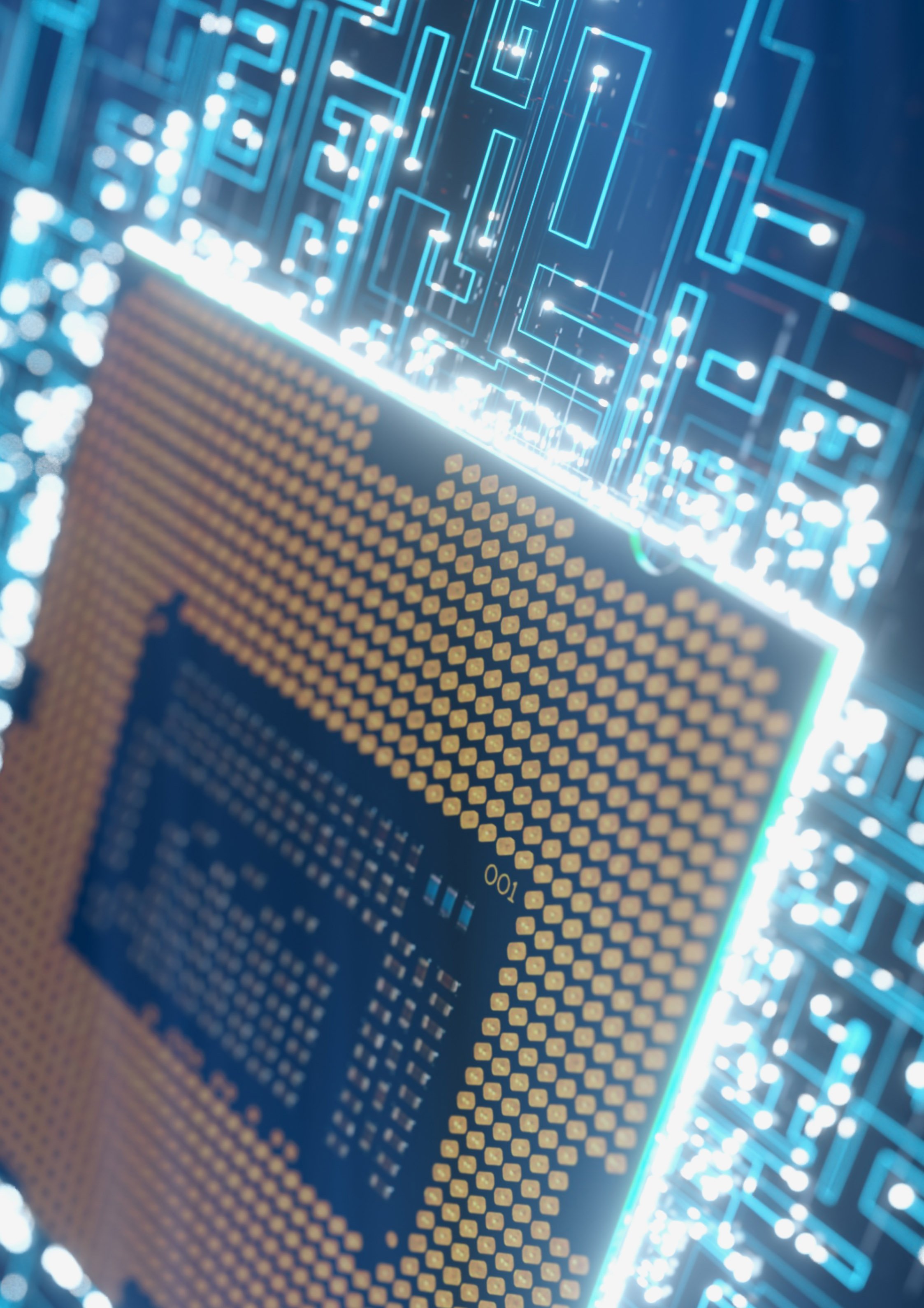
您想減少失效分析樣品製備的時間和成本嗎?
Rodrigo Delgadillo Blando 等人撰寫的“Pairing Laser Ablation and Xe Plasma FIB-SEM: An Approach for Precise End-Pointing in Large-Scale Physical Failure Analysis in the Semiconductor Industry”是一篇在 2021 年 ISTFA 會議上發表的論文,它描述了一種使用 ps 激光燒蝕工具和 Xe 等離子體 FIB-SEM 系統製備微電子器件大體積橫截面的創新方法。這是一項非常相關的前沿研究,旨在提高微電子器件故障分析的效率和準確性。
作者解決了與訪問微電子器件中深埋結構以進行物理失效分析(PFA)相關的挑戰。傳統方法,如機械拋光或Ga+ FIB銑削,對於大容量樣品製備來說要麼太慢,要麼太有害。本文提出了一種將ps激光燒蝕工具的快速材料去除率與Xe Plasma FIB-SEM系統的精確端點和精細表面拋光能力相結合的方法。本文提出,該方法能夠快速準確地對微電子器件進行PFA,並且由於兩種工具同時和連續運行,因此提高了生產率。
 該研究證明瞭所提方法在各種應用中的有效性,例如製備由敏感材料和複雜結構組成的AMOLED移動顯示器的無損傷和無分層橫截面。本文還討論了製備具有不同焊球材料和尺寸的倒裝晶元封裝的橫截面,這需要高解析度成像和分析,以及用於端點的CAD導航、數據關聯和位圖疊加。用於端點的 CAD 導航、數據關聯和點陣圖疊加。
該研究證明瞭所提方法在各種應用中的有效性,例如製備由敏感材料和複雜結構組成的AMOLED移動顯示器的無損傷和無分層橫截面。本文還討論了製備具有不同焊球材料和尺寸的倒裝晶元封裝的橫截面,這需要高解析度成像和分析,以及用於端點的CAD導航、數據關聯和位圖疊加。用於端點的 CAD 導航、數據關聯和點陣圖疊加。
本文還介紹了相關問題,例如 CAD 導航、數據關聯和用於端點的點圖疊加。結果表明,所提方法可以產生高品質的截面,偽影和損傷最小,並能揭示裂紋、空隙、金屬間化合物和分層等缺陷。
使用TESCAN解決方案優化您的半導體故障分析: 使用TESCAN解決方案進行主IC封裝故障分析
瞭解這項引人注目的研究: 激光燒蝕和 Xe 等離子體 FIB-SEM 配對:半導體行業大規模物理故障分析中的精確端點方法 |ISTFA論文集 |ASM 數位圖書館 (asminternational.org)
使用TESCAN解決方案優化您的半導體故障分析: 使用TESCAN解決方案進行主IC封裝故障分析

瞭解最新的半導體技術
與行業專業人士、研究人員和學者一起探索半導體的未來。我們的專家團隊期待與行業專業人士,研究人員和學者合作,瞭解您的要求,並討論TESCAN的解決方案如何支援您的研發計劃。
