IC封裝
失效分析
使用 TESCAN解決方案
體驗Plasma FIB-SEM(PFIB)
以及創新的TESCAN大體積切削工作流程
新論文
優化半導體故障分析:結合雷射燒蝕(Laser)和Plasma FIB-SEM(PFIB)的應用
解開獨立式雷射燒蝕技術(stand-alone ps-laser)與Plasma FIB-SEM(PFIB) 相結合的全部潛力,這樣的結合使微電子元件故障分析課題中用戶想實現的高速性、精確性都比以往任何時候更容易。閱讀我們的最新的技術,瞭解我們如何通過設備間的協同合作,並可持續發展改善對樣品分析生產效率的提升!

隨著半導體的進步,IC 封裝失效分析實驗室面臨著前所未有的挑戰。 全球半導體公司致力於挑戰複雜的通信元件,和更多複合式功能的3C電子產品,開發最先進的晶片包含封裝技術,和微縮化的晶片; 與此同時解決複雜的半導體故障分析挑戰包含不斷創新的封裝架構、和更縮小的晶片,以及更敏感材料是一項艱鉅的任務。
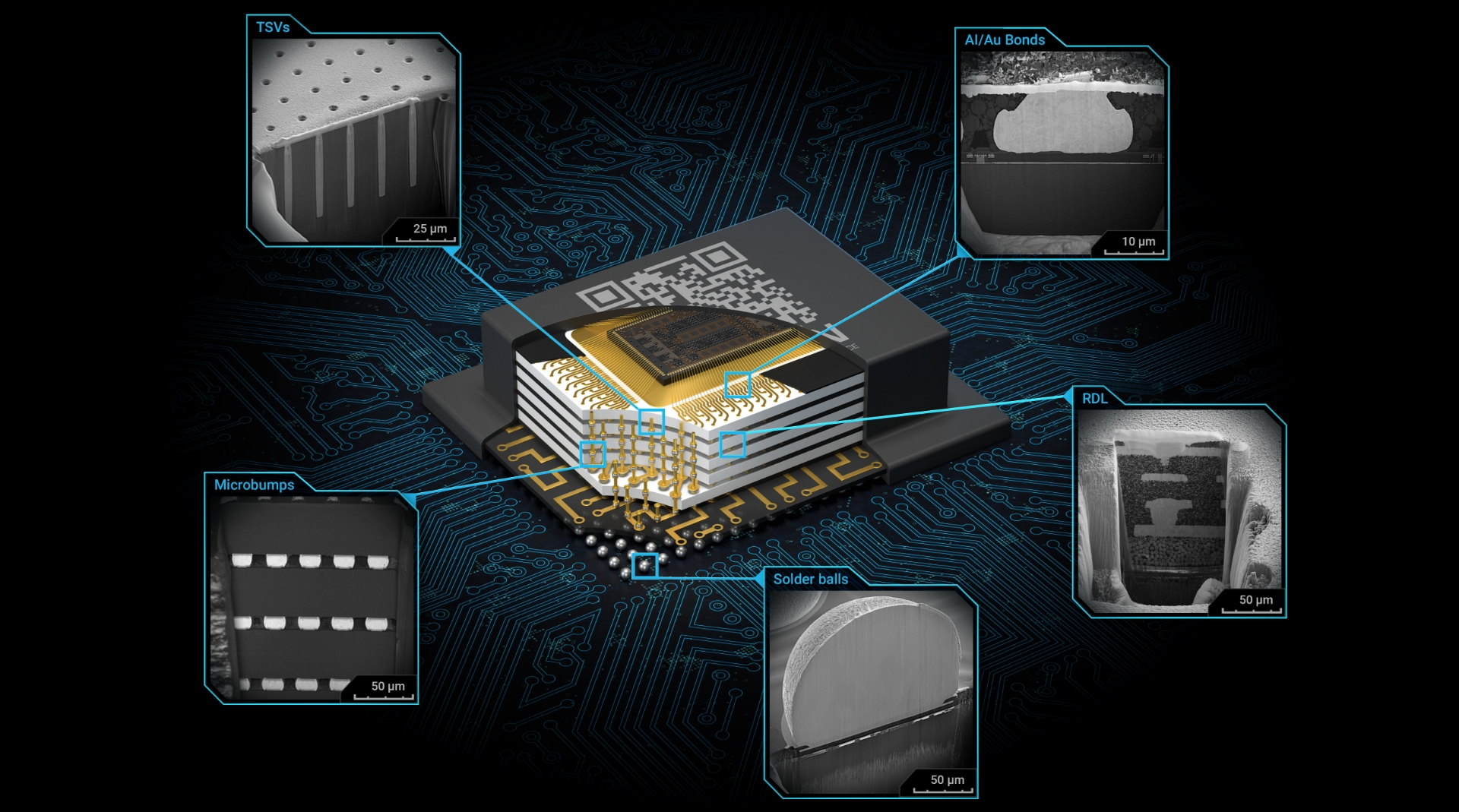
利用頂尖的 TESCAN 解決方案轉化為可持續發展的 IC 封裝失效分析
持續發展開發的IC封裝故障分析取決於FA工具提供的各種專業知識,包含廣泛的非破壞性分析應用,和破壞性分析應用。TESCAN為客戶提供創新的解決方案,包括非破壞性Micro-CT故障分析應用,及破壞性Plasma FIB-SEM(PFIB) SOLARIS X以及大體積切削工作流程,該工作流程無縫地結合了雷射燒蝕(Laser)和Plasma FIB-SEM(PFIB)技術。
此外,TESCAN與歐洲合作夥伴合作成為FA4.0的一個成員,該專案組之旨在在眾多不同種類的故障分析儀器之間合作建立與分享更流暢有效的故障分析工作流程,並為微電子故障分析實驗室的數位化資訊提供貢獻更多的實際研究數據。了解有關FA4.0的更多資訊!
親眼看看這些解決方案是如何將IC封裝故障分析提升到全新的水平。
瞭解我們的尖端解決方案
探索TESCAN FIB-SEM(Ga-FIB)
體驗極致的Plasma FIB-SEM(PFIB),用於IC封裝故障分析中的深層切割和高解析SEM視野下的停刀端點。
深入瞭解TESCAN大體積切削工作流程

利用Plasma FIB-SEM(PFIB),和獨立式雷射燒蝕技術(stand-alone ps-laser),以及其他FA工具的協同工作進行毫米級樣品製備和分析。
問題?
對線上演示感興趣?
我們的全球團隊已經準備好隨時可提供有關TESCAN FIB-SEM對於半導體和IC封裝故障分析解決方案。
